
News
在半導體行業,隨著摩爾定律逐漸逼近物理極限,通過三維集成提升芯片性能已成為核心發展方向。2.5D/3D封裝、異構集成等先進封裝技術的普及,對垂直互連密度和基板性能提出了更高要求。傳統的硅基板在高頻信號傳輸、制造成本和工藝復雜度等方面的局限性日益凸顯,而玻璃基板憑借獨特優勢,正成為下一代芯片基板的理想選擇。

玻璃通孔(TGV, Through Glass Via)作為實現玻璃基板三維集成的關鍵技術,猶如芯片世界的“微型通道”,引領著半導體封裝從“硅基時代”向“玻璃基時代”過渡。
玻璃通孔(TGV),是在玻璃基板上制作的垂直貫通的微小通孔,并在通孔中填充導電材料,以實現不同層面之間電氣連接的技術。TGV被認為是下一代三維集成封裝的關鍵技術之一,用于替代硅通孔(TSV,Through Silicon Via)轉接板和有機物基板。
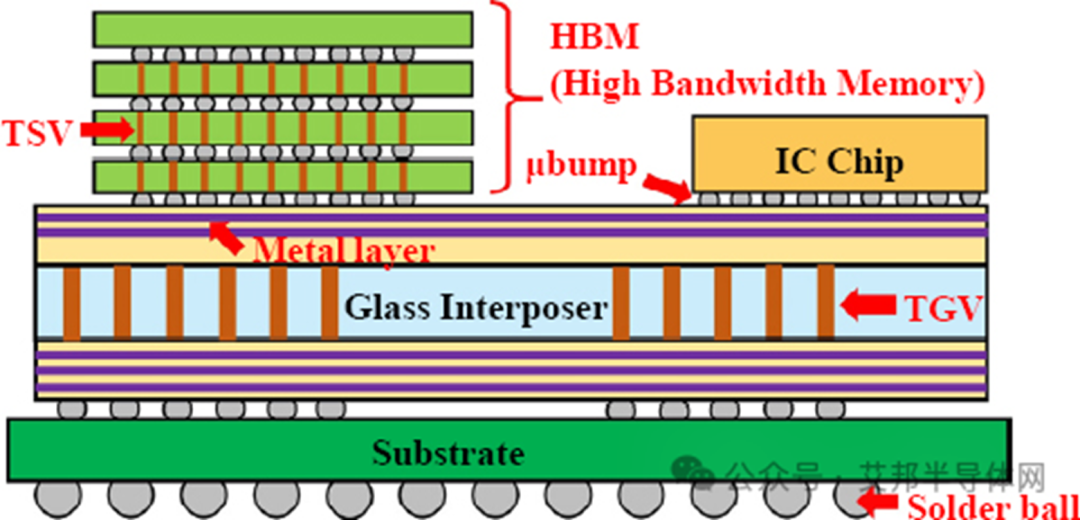
在目前的2.5D封裝中,臺積電的CoWoS(Chip-on-Wafer-on-Substrate)封裝的核心之一為硅轉接板及 TSV工藝,但其存在成本高和電學性能差等不足。而玻璃轉接板及TGV工藝具有低成本、易獲取、低翹曲、高頻電學特性優良等特點,其優勢主要包括:

TGV通常由直徑為10μm-100μm的微通孔組成,以高品質硼硅玻璃、石英玻璃為基材,通過種子層濺射、電鍍填充、化學機械平坦化、RDL再布線,Bump工藝引出實現3D互聯。對于先進封裝領域的各種應用,每片晶圓上通常需要形成數萬個TGV通孔并對其進行金屬化,以獲得所需要的導電性。TGV微通孔需具有高精度、窄節距、側壁光滑以及良好的垂直度,以確保后續金屬化工藝的質量和電學性能的穩定。額外還要考慮到玻璃材料的易碎性和化學惰性,成孔過程中需避免對玻璃造成損傷,保持表面完整性。

目前TGV的成孔技術包括噴砂法、光敏玻璃法、聚焦放電法、等離子刻蝕法、激光燒蝕法、電化學法、激光誘導刻蝕法等。綜合比較各種玻璃通孔制造技術,激光誘導刻蝕法具有高速度、無掩模、高深寬比、一致性好、無裂紋等優勢,具備大規模應用前景。

激光誘導刻蝕法通過超快脈沖激光誘導玻璃產生連續的改性區,相比未改性區域的玻璃,改性后的玻璃在酸性或堿性刻蝕液中的刻蝕速率更快,基于這一現象可以在玻璃中制作出大規模通孔結構。通過激光脈沖能量、光束形狀、聚焦條件、刻蝕液濃度、刻蝕溫度等不同參數的控制,可制備出理想的TGV玻璃通孔。
Workshop of Photonics(WOP)公司成立于2004年,總部位于立陶宛維爾紐斯,是一家致力于超快激光微加工技術研發的科技公司。作為全球領先的飛秒激光微加工設備及解決方案提供商,WOP擁有先進的激光微加工應用實驗室及十數套激光加工系統,用于前沿工藝開發和小批量生產,可為客戶提供研發打樣和代加工服務,并能按需定制飛秒激光微加工設備。

WOP公司在飛秒激光微加工領域擁有超過20年的技術積累,對玻璃、陶瓷、合金等硬脆材料以及聚合物、塑料等柔性材料的微加工均有豐富的經驗。特別是針對玻璃材料的加工,WOP開發了多種先進工藝并持有相關專利,可實現高效、精準的玻璃切割、鉆孔、開槽、焊接、選擇性燒蝕、彩色標記以及光束整形元件加工等應用。其技術與產品已廣泛用于半導體、生物醫學、光通信、先進制造、消費電子等多個領域。

針對TGV先進封裝應用,WOP開發了選擇性激光誘導刻蝕(SLE,Selective Laser-induced Etching)技術,可實現高效率、高質量的玻璃改性成孔工藝,滿足300mm玻璃晶圓或600mm玻璃面板的TGV加工。其加工優勢包括成孔速度快、無漏孔、孔徑一致性高、側壁粗糙度小,無崩邊、無微裂紋,可加工通孔或盲孔,且孔的形狀、錐度靈活可控,滿足工業級大規模TGV通孔加工需求。具體指標如下:玻璃厚度<1.1mm,微孔直徑最小10um,深徑比最大100:1,側壁粗糙度Ra<80nm,孔徑一致性高達99%,圓度高達98%,版圖加工速度目前為300-400孔/秒,年內有望突破2000孔/秒。
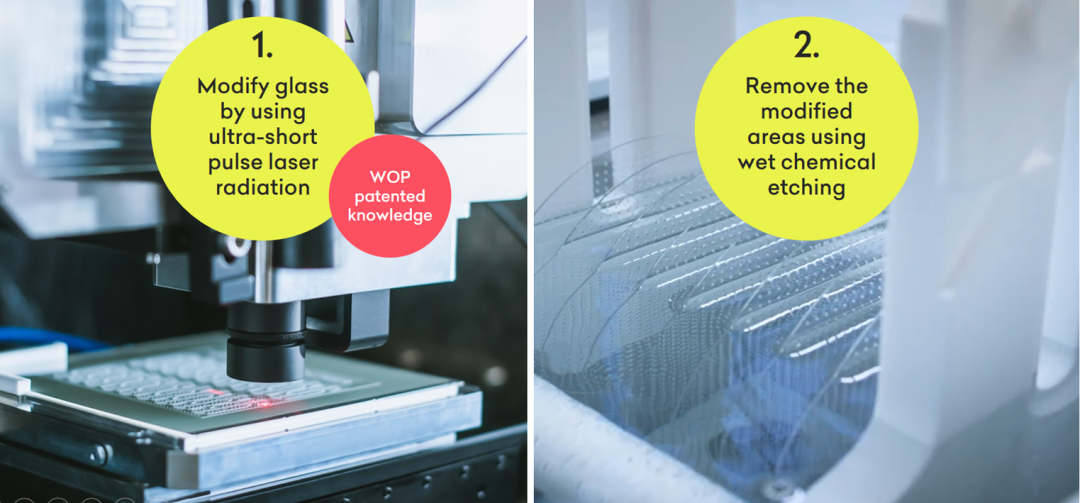




此外,基于SLE工藝,WOP還可以提供光纖對準陣列(FAA,Fiber Alignment Arrays)的研發與代加工服務,為高速光通信系統關鍵組件的生產提供解決方案。FAA可實現高精度的一維或二維光纖與光纖,光纖與芯片的對準耦合,滿足高密度的光互聯需求。

FAA的制備對通孔的形貌、孔徑公差及定位精度要求較高,WOP借助先進的生產工藝,不僅可以加工普通的直通孔結構,還能制備帶傾角的通孔以及開口更復雜的漏斗形、階梯形或圓錐形的結構,方便插入光纖。

近期,凌云光與WOP公司的合作進一步加強,在TGV、FAA、CPO等先進封裝相關領域深度合作,共同推進WOP飛秒激光微加工技術的本地化應用,助力國內半導體先進封裝產業發展!
?
2022-07-14
2023-03-10
2025-07-16
2022-05-27
2022-04-28